12인치 반도체 가늠터(테스트베드) 구축완료 및 공식 서비스 개시
작성일 2021-03-16 부서 융합기술과



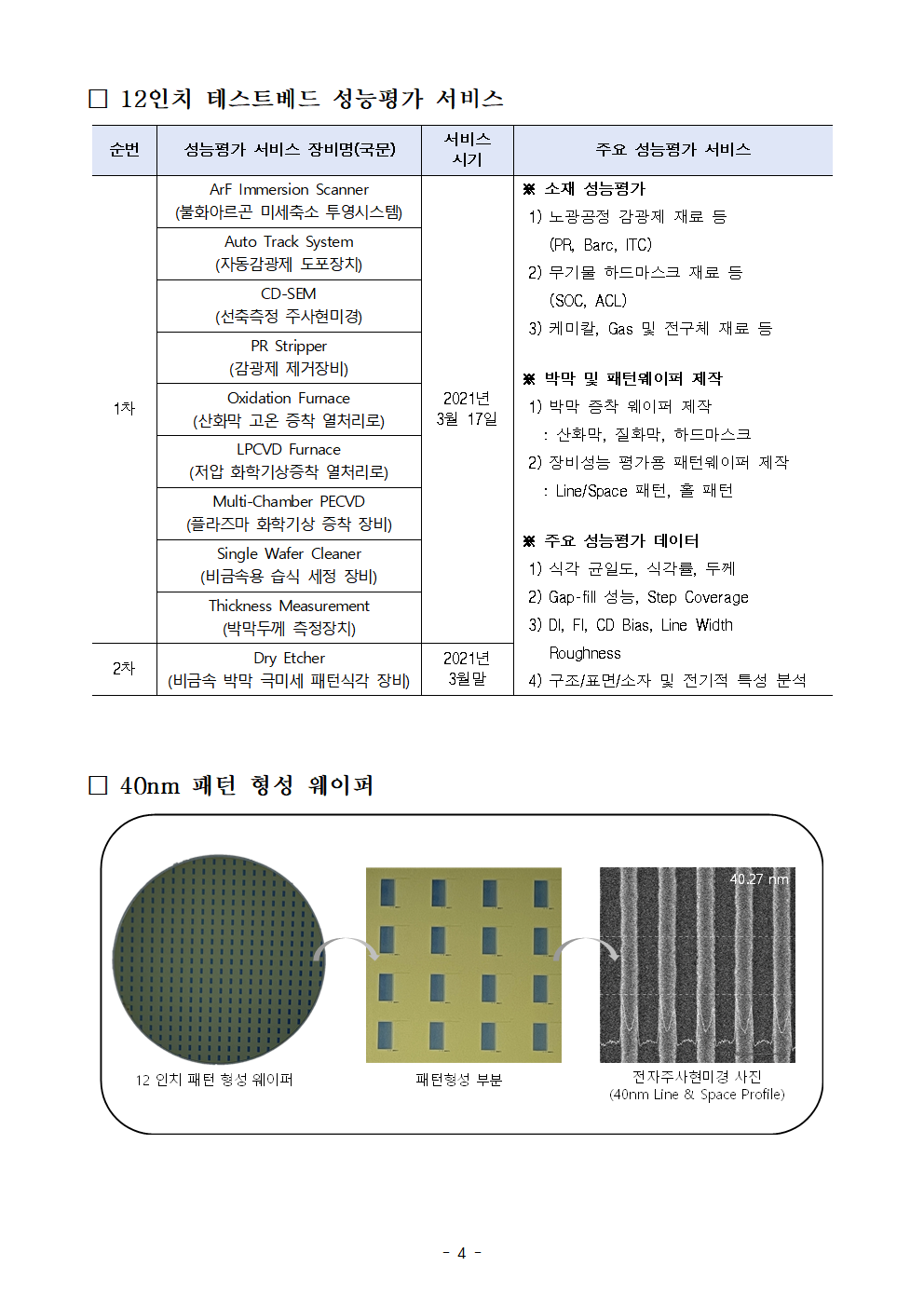
나노종합기술원, 12인치 반도체
가늠터(테스트베드) 공식서비스 개시
- 국내 반도체 소부장 기업과 불화아르곤(ArF) 액침(Immersion)용 감광제,
극자외선(EUV) 초박막 소재․부품 등 국산화 기술개발 본격 지원 -
□ 과학기술정보통신부(장관 최기영, 이하 ‘과기정통부’)가 국내최초로 나노종합기술원(원장 이조원, 이하 ‘종기원’)에 12인치 반도체 테스트베드(이하 ‘12인치 테스트베드’) 구축을 완료하고, 3월 17일부터 국내 산·학·연 이용자에게 공식서비스를 본격 추진한다.
ㅇ 반도체 생산용 소재․부품은 2019년 7월 일본의 수출규제에 따라 우리나라에 소재․부품․장비(이하 ‘소부장’) 기술자립화에 대한 경각심을 불러일으킨 대표품목이다.
ㅇ 일본 수출규제 이전에도 국내 반도체 소부장 기업들은 대기업 생산환경과 유사한 12인치 테스트베드가 국내에 없어, 대기업 납품에 필요한 수준의 평가결과를 획득하는데 많은 애로가 있었다.
- 이에 대부분의 중소기업들은 많은 비용과 시간을 들여 해외 테스트베드를 이용하거나, 종기원의 8인치 장비를 활용한 기초평가 수준에서 만족할 수밖에 없는 상황이었다.
※ 반도체 대기업(삼성전자, SK하이닉스반도체 등)에서 요구하는 12인치 웨이퍼上에서의 소재 균일도, 결함 등 완성도 평가가 국내에서 불가능
□ 이러한 문제를 해결하기 위해 과기정통부는 2019년 8월 종기원을 반도체 소부장 12인치 테스트베드 운영기관으로 지정하고 청정실과 핵심장비 구축, 장비안정화 작업을 신속히 추진하여 2021년 3월 17일부터 공식서비스를 개시하게 되었다.
※ 국비 총 450억원을 투자하여 핵심장비 10대 구축, 공정기술 개발 추진
□ 향후 국내 반도체 소부장 기업들은 종기원의 12인치 테스트베드를 활용하여 반도체 핵심소재 성능 테스트를 신속하게 지원받을 수 있게 되어, 반도체분야 소부장 기술자립화에 소요되는 시간과 비용을 획기적으로 절감할 수 있게 되었다.
ㅇ 이조원 종기원 원장은 “현재 12인치 테스트베드는 40nm 패턴웨이퍼 제작이 가능한 인프라로, 반도체 핵심소재(감광제 등)와 장비개발을 집중 지원할 예정이며, 향후 20nm급 패턴웨이퍼 제작과 부품 테스트를 지원할 수 있는 추가 장비구축 및 공정기술 개발을 추진할 계획이다”라고 밝혔다.
□ 과기정통부 김봉수 기초원천연구정책관은 “반도체 산업은 국가 수출의 20%를 담당하는 핵심 주력산업으로, 대기업뿐만 아니라 다양한 소부장 중소기업들과 대학․출연연 연구자들이 협업하는 대규모 연구․산업 생태계를 갖추고 있는 분야”라고 하며,
ㅇ “과기정통부는 앞으로 반도체 분야의 발전을 위해 기초․원천 연구지원과 병행하여, 수준 높은 인프라 지원을 위한 투자확대, 기능고도화 등의 노력을 지속적으로 추진하겠다”고 밝혔다.
붙임 : 12인치 반도체 테스트베드 장비 및 주요사양 1부.
별도송부 : 12인치 테스트베드 관련사진
붙임 12인치 반도체 테스트베드 장비 및 주요사양
□ 12인치 반도체 테스트베드 장비 및 주요사양
장비명 모델 제조사 주요 사양
포토공정 ArF Immersion TWINSCAN XT1900Gi ASML ArFexcimer laser (193nm)
Scanner Reduction Ratio: 1:4
DOE : 11EA type
Wafer size: 12”(notch)
Illumination : 1.35NA
Resolution : 40nm
Overlay : < 6nm
Auto Track Lithius-Pro-i TEL THC •Wafer size: 12” Wafer
System PRrotation speed : 10-4000 rpm
Acceleration : 100-30,000rpm/sec
Temperature uniformity: ≤±1℃
3-COT, 3-BCT, 3-ITC, 6-DEV
- Temperature: 20~27℃
- Humidity: 30~35%
CD-SEM CG6300 Hitachi High Ip(max:500pA) availability
Precision: 0.15nm
Effective Resolution : 1.35nm
Detector : Upper – direct
Throughput : 60WPH
식각공정 Dry Etcher FLEX GX Lam CCP Type
Research 2Mhz, 27Mhz, 60Mhz (RF Pulsing)
Dual Upper Electrode Temp Tuning
Etch rate (Oxide) : ~ 3000Å / min
Reliable Uniformity: <± 5%
Tun Gas : O2, C4F8, C4F6, CH2F2
Oxide, Nitride, ACL etch
PR Stripper SUPRAN PSK Power Source: Microwave 5kW
2 Chamber system, Automatic robot arm handling system(Dual Pick available)
Temp range: 150 ℃ ~ 300 ℃
Ashing rate: > 13㎛ / min
Reliable Uniformity: <± 5%
Gas: O2, N2, H2N2
박막공정 Oxidation Furnace TERA300SE 원익IPS Batch Process : 100wafers
EFEM (Stocker + FIMS)
FOUP Transfer Robot
Wafer Transfer Robot
5 Zone Heating Control
Boat rotation
External torch system
LPCVD Furnace DJ-1224VN KEK Batch Process : 100wafers
EFEM (Stocker + FIMS)
FOUP Transfer Robot
Wafer Transfer Robot
5 Zone Heating Control
Boat Rotation
Cold Trap
Multi-Chamber Producer SE AMAT 2 Loadports, Single-Wafer Processing
PECVD 3 Twin Process Chamber / 1 System
- TEOS USG
- SiH4-Based SiO2/SiNx/SiON
- Amorphous Carbon Layer
RPS Clean
Single Wafer PSM-302 무진전자 2 Process Chamber / 1 System
Cleaner Wafer Transfer Robot
2 Dispenser / Chamber
Pre Dep Clean : DHF, SC-1
Post Etch Clean : LAL15, DSP
IPA/N2 Spin Dryer
Chemical Delivery System
측정계측 Thickness Measurement Spectra FX200 KLA 3 Measurement Tools / 1System
Spectroscopic Ellipsometer,
Spectroscopic Reflectometer,
Stress Gauge
2 Loadports, Single-Wafer Processing
Wavelength Range : 190 ~ 800 nm
Thick.Measurement Range : 0 ~ 40 ㎛
□ 12인치 테스트베드 성능평가 서비스
순번 성능평가 서비스 장비명(국문) 서비스 시기 주요 성능평가 서비스
1차 ArF Immersion Scanner 2021년 ※ 소재 성능평가
(불화아르곤 미세축소 투영시스템) 3월 17일 1) 노광공정 감광제 재료 등
(PR, Barc, ITC)
2) 무기물 하드마스크 재료 등
(SOC, ACL)
3) 케미칼, Gas 및 전구체 재료 등
※ 박막 및 패턴웨이퍼 제작
1) 박막 증착 웨이퍼 제작
: 산화막, 질화막, 하드마스크
Auto Track System 2) 장비성능 평가용 패턴웨이퍼 제작
(자동감광제 도포장치) : Line/Space 패턴, 홀 패턴
CD-SEM
(선축측정 주사현미경) ※ 주요 성능평가 데이터
PR Stripper 1) 식각 균일도, 식각률, 두께
(감광제 제거장비) 2) Gap-fill 성능, Step Coverage
Oxidation Furnace 3) DI, FI, CD Bias, Line Width
(산화막 고온 증착 열처리로) Roughness
LPCVD Furnace 4) 구조/표면/소자 및 전기적 특성 분석
(저압 화학기상증착 열처리로)
Multi-Chamber PECVD
(플라즈마 화학기상 증착 장비)
Single Wafer Cleaner
(비금속용 습식 세정 장비)
Thickness Measurement
(박막두께 측정장치)
2차 Dry Etcher 2021년
(비금속 박막 극미세 패턴식각 장비) 3월말
□ 40nm 패턴 형성 웨이퍼
'판교핫뉴스1' 카테고리의 다른 글
| 코로나19 이후 경제,사회 변화를 파악할 수 있는 통계 시각화 웹사이트 개설 (0) | 2021.03.16 |
|---|---|
| 바이오헬스(감염병 포함) 분야 , 관계부처 연구개발 예산전략회의 개최 (0) | 2021.03.16 |
| 2020년 정보보호실태조사 결과 발표 (0) | 2021.03.16 |
| 2020년 데이터산업현황조사 결과 (0) | 2021.03.16 |
| FTA활용, 중소중견기업에게 성장의 돌파구!-「통상조약국내대책위원회 활용분과」회의개최 (0) | 2021.03.16 |
